2024年第四届“望友杯”全国电子制造行业PCBA设计大赛分赛区比赛报名开始啦!
去除铜柱凸块倒装芯片上焊剂的研究
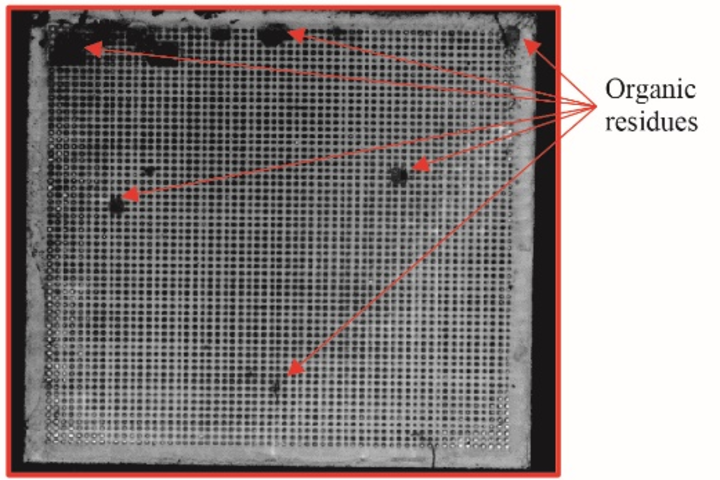
倒装芯片技术是一种将IC芯片器件与沉积在芯片焊盘上的焊点的外部电路互连的方法。倒装芯片技术成本低,封装密度高,能够保持或是提高电路可靠性的同时表现出更佳的工作性能,还能实现高I/O密度,因此在电子行业越来越普遍。然而,有研究表明焊料凸点技术在125μm间距以下有局限性,因为它在制造和组装中面临极大的挑战。随着间距变小,间距的纵向高度及焊点的可靠性都会降低,短路的风险也会增加。
时间:
2024-04-19 17:58:17
浏览量:
3316
细间距焊盘锡膏印刷分享(2)
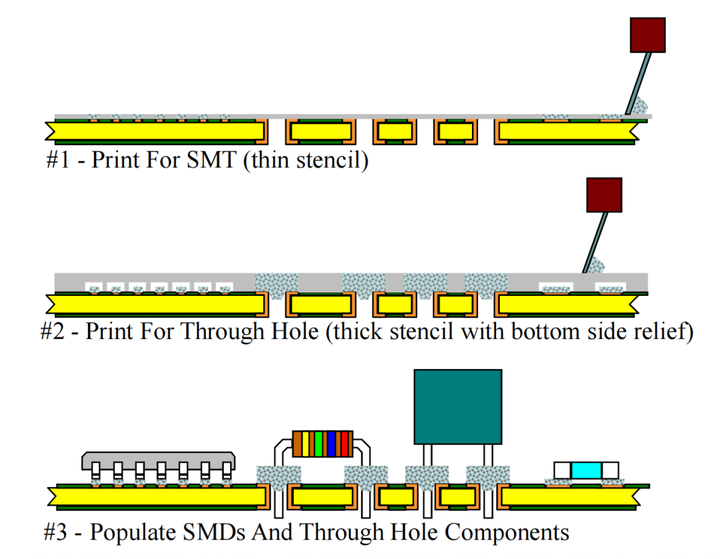
Part 1中我们讲到钢网开孔形状对锡膏下锡状况的对比。纽约州立大学的对此作了研究分析:Paired-T分析表明,在相通标称体积下,圆形开孔下锡情况要比方形开孔要更好。所以,如果倒装芯片、CSP和μBGA等元件,锡膏体积成为保证良好焊接的关键点时,钢网设计使用圆形开孔是最佳选择。同时,降低钢网厚度以及减小锡球的体积都对下锡有良好的效果。
时间:
2024-01-19 18:00:00
浏览量:
7914
技术论文|大尺寸BGA器件侧掉焊盘问题分析

大尺寸BGA器件侧掉焊盘问题分析王世堉,王 剑(中兴通讯股份有限公司,广东 深圳518057)摘 要:本文通过对BGA器件侧掉焊盘问题进行详细的分析,发现在BGA应用中存在的掉焊盘问题,并结合此次新发
时间:
2023-05-14 22:51:00
浏览量:
15461
SMT贴片加工中将元件焊接到PCB上两种方法的区别
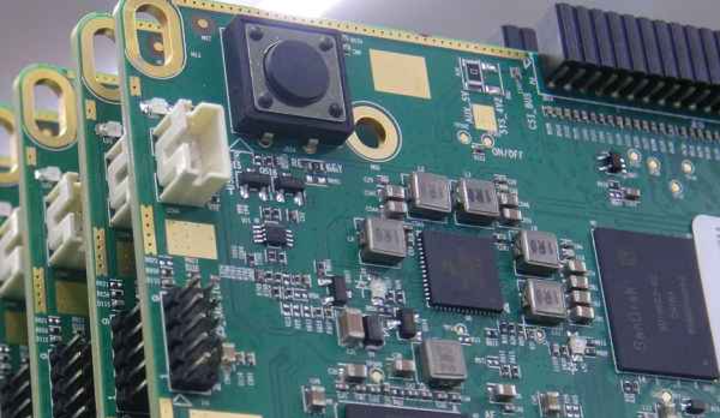
对于SMT元件,焊膏直接涂在焊盘上,将元件的引线保持在一个位置。当PCB穿过专用回流焊时,焊膏会回流。在这里,形成了坚固的焊点。如果您使用的是混合型,则需要同时使用波峰焊和回流焊。有现成的自动取放机器可以可靠地处理各种组件。







