2024年第四届“望友杯”全国电子制造行业PCBA设计大赛分赛区比赛报名开始啦!
点胶工艺介绍之Underfill后BGA维修

大家熟知的无铅焊锡的焊接及熔化的温度需要>220°C, 而Underfill胶水的爆胶温度上限为210°C,两者的温控窗口仅为10°C。鉴于手机器件的精密化排布,BGA周边3mm以外就会有其他需点胶的器件分布,如何在维修时可以顺利的完成BGA拆装更换,且不影响周边已点胶的器件,是维修时业界同仁倍受困扰的问题。
时间:
2024-04-29 22:00:00
浏览量:
550
细间距焊盘锡膏印刷分享(2)
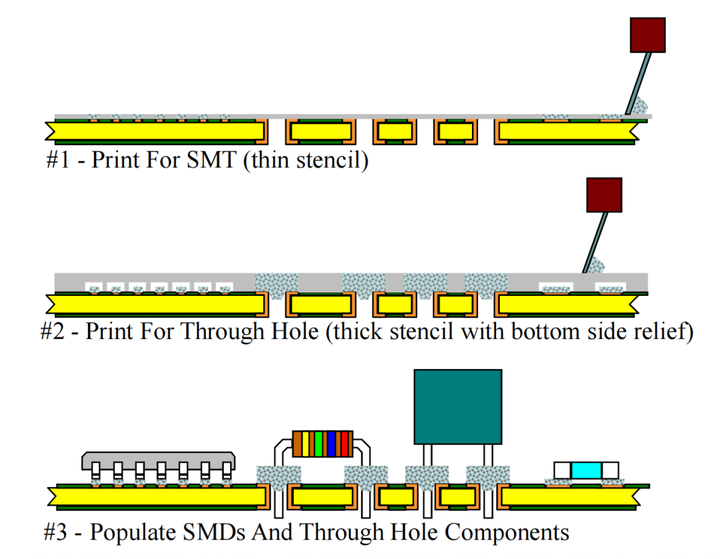
Part 1中我们讲到钢网开孔形状对锡膏下锡状况的对比。纽约州立大学的对此作了研究分析:Paired-T分析表明,在相通标称体积下,圆形开孔下锡情况要比方形开孔要更好。所以,如果倒装芯片、CSP和μBGA等元件,锡膏体积成为保证良好焊接的关键点时,钢网设计使用圆形开孔是最佳选择。同时,降低钢网厚度以及减小锡球的体积都对下锡有良好的效果。
时间:
2024-01-19 18:00:00
浏览量:
7930
技术论文|大尺寸BGA器件侧掉焊盘问题分析

大尺寸BGA器件侧掉焊盘问题分析王世堉,王 剑(中兴通讯股份有限公司,广东 深圳518057)摘 要:本文通过对BGA器件侧掉焊盘问题进行详细的分析,发现在BGA应用中存在的掉焊盘问题,并结合此次新发
时间:
2023-05-14 22:51:00
浏览量:
15583
【优秀论文】BGA芯片二次回流掉件风险评估
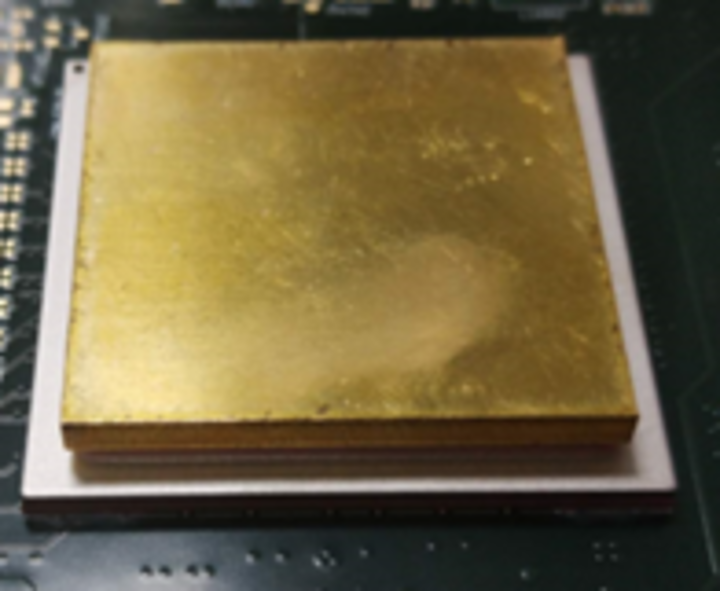
BGA芯片二次回流掉件风险评估马恩旭,孙 磊,邱华盛中兴通讯电子制造职业学院摘 要:5G芯片集成度增加导致对散热要求高,需要增加金属盖的质量以提高散热能力,导致BGA芯片重量增加,二次回流存在掉件风险